劉益春院士團隊李炳生教授MOCVD課題組研究論文---引入GaON成核層實現β-Ga?O?/GaN高性能紫外探測器
由集成光電子全國重點實驗室東北師范大學的研究團隊在學術期刊 Materials Today Physics 發布了一篇名為 Enhanced performance UV photodetectors based on the β-Ga2O3/GaN photodiode of the reversed substitution growth with introduction nucleation layer of GaON by oxygen plasma treatment(通過氧等離子體處理引入 GaON 成核層進行反向替代生長,增強基于 β-Ga2O3/GaN 光電二極管紫外光電探測器的性能)的文章。
1. 項目支持
本研究得到了國家自然科學基金(62274027和62404039)、寬帶隙光電子材料與器件集成學科創新引智基地(B25030)松山湖材料實驗室開放研究基金(2023SLABFK03)和吉林省(20220502002GH)、CPSF博士后科研流動項目(GZC20230416)以及中央高校基本科研業務費專項資金(2412024QD010)的支持。
2. 背景
β-Ga2O3 因高吸收系數及紫外區域的高效光子吸收成為理想紫外光電探測器材料。為提升光電轉換效率,常通過構建異質結以促進載流子分離與傳輸。其中,β-Ga2O3/GaN異質結得益于兩者間的較小晶格失配而備受關注。傳統外延 n-β-Ga2O3/p-GaN 異質結因界面勢壘阻礙載流子輸運并降低檢測效率。而反向替代法因高溫氧化速度過快易造成表面熱損傷。本研究提出氧等離子體處理(OPT)輔助反向替代法,在 GaN 表面預先形成 GaON 成核層。并系統的研究了GaON 層對后續氧化的性能影響。
3. 文章摘要
展示了一種具有偏壓可調光譜響應(UVC 波段到 UVA-UVC波段)的高性能 β-Ga2O3/GaN 紫外光電探測器。該器件是通過一種新的反向替代生長路線制造的,通過 OPT 在 GaN 表面引入 GaON 成核層,用于 β-Ga2O3 合成。詳細分析了成核層對 GaN 在氧氣環境下高溫轉化為 β-Ga2O3 的影響。X 射線衍射(XRD)證實,形成了具有窄線寬的(-201)擇優取向單斜相 β-Ga2O3。X射線光電子能譜(XPS)和原子力顯微鏡(AFM)證實,經OPT處理的 β-Ga2O3 表面上的氧空位(VO)和表面粗糙度的均方根(RMS)都降低了,從而與電極形成了更好的界面接觸。同時,內部 VO 的增加增強了材料的導電性,從而提高了光電響應性能。金屬半導體金屬(MSM)器件實現了超高的探測能力(響應度= 653 A/W,探測率= 2.9×1015 Jones),并通過改變施加的偏壓在日盲窄帶和 UVA-UVC 寬帶之間切換響應光譜。瞬態響應時間以毫秒為單位。在垂直型 β-Ga2O3/GaN 光電二極管中,在 -10 V 的偏壓下,光電探測器的響應度和探測率達到 2.1 A/W 和 7.2×1013 Jones,瞬態響應時間快(上升時間=0.24 ms,衰減時間=17.1 ms)。
4. 創新點
•使用反向替代法,殘留的氮(作為受體)導致所得 Ga2O3 中的費米能級低于 GaN。改變光生載流子的輸運方向,有助于避免能帶偏移的界面勢壘。
•OPT 輔助反向替代法,在熱氧化前引入 GaON 成核層,降低氧化速率。
•有效控制了 β-Ga2O3 中的氧空位,減少了表面缺陷,提高了材料的導電性。
•通過控制施加的偏壓,實現了從 UVC 波段到 UVA-UVC 波段的可調諧檢測。
5. 結論
在這項研究中,β-Ga2O3 薄膜在GaN上成功地進行了熱氧化。通過調節施加的偏壓的大小,實現了從 UVC 到 UVC-UVA 波段的可調檢測。此外,通過 OPT 引入 GaON 的方法降低了 β-Ga2O3 的表面粗糙度,有效地控制了表面和內部的氧空位。在提高樣品電導率的同時,表面缺陷狀態也得到了改善。MSM 型 β-Ga2O3/GaN 異質結光電探測器的響應度在 10 V 下從 79 A/W 顯著提高到 653 A/W。同時,瞬態響應速度得到了提高,上升/衰減時間分別為 0.29 ms/68 ms。此外,垂直型器件得到了進一步優化,實現了 0.24 ms 的上升時間和 17 ms 的衰減時間。這項研究為提高紫外光電探測器的性能提供了一種實用的方法。
6. 圖文內容

圖1. Ga2O3 生長工藝流程圖。

圖2. Ga 3d 的 XPS 光譜:(a)未經 OPT 處理的 GaN 和 (b) 經過 OPT 處理的 GaN。(c)經過 OPT 處理的 GaN 原子排列分布示意圖。

圖3.(a) 樣品 A(未經 OPT 處理的 GaN 氧化后的氧化鎵)、樣品B(經 OPT 處理的 GaN 氧化后的氧化鎵)和 GaN 的 XRD 光譜。(b) 經過和未經過 OPT 的 GaN 的氧化生長速率。(c,d)掃描面積為 5μm×5μm 的樣品 A 和樣品 B 的AFM 圖像。(e) 樣品 A、樣品 B 和 Ti 的 KPFM 和電位圖。

圖4. 樣品 A 和樣品 B 的 XPS 光譜:(a,b)Ga 3d;(c,d)O 1s;(e,f)Ar+ 蝕刻后的 Ga 3d;Ar+ 蝕刻后的(g,h)O 1s。
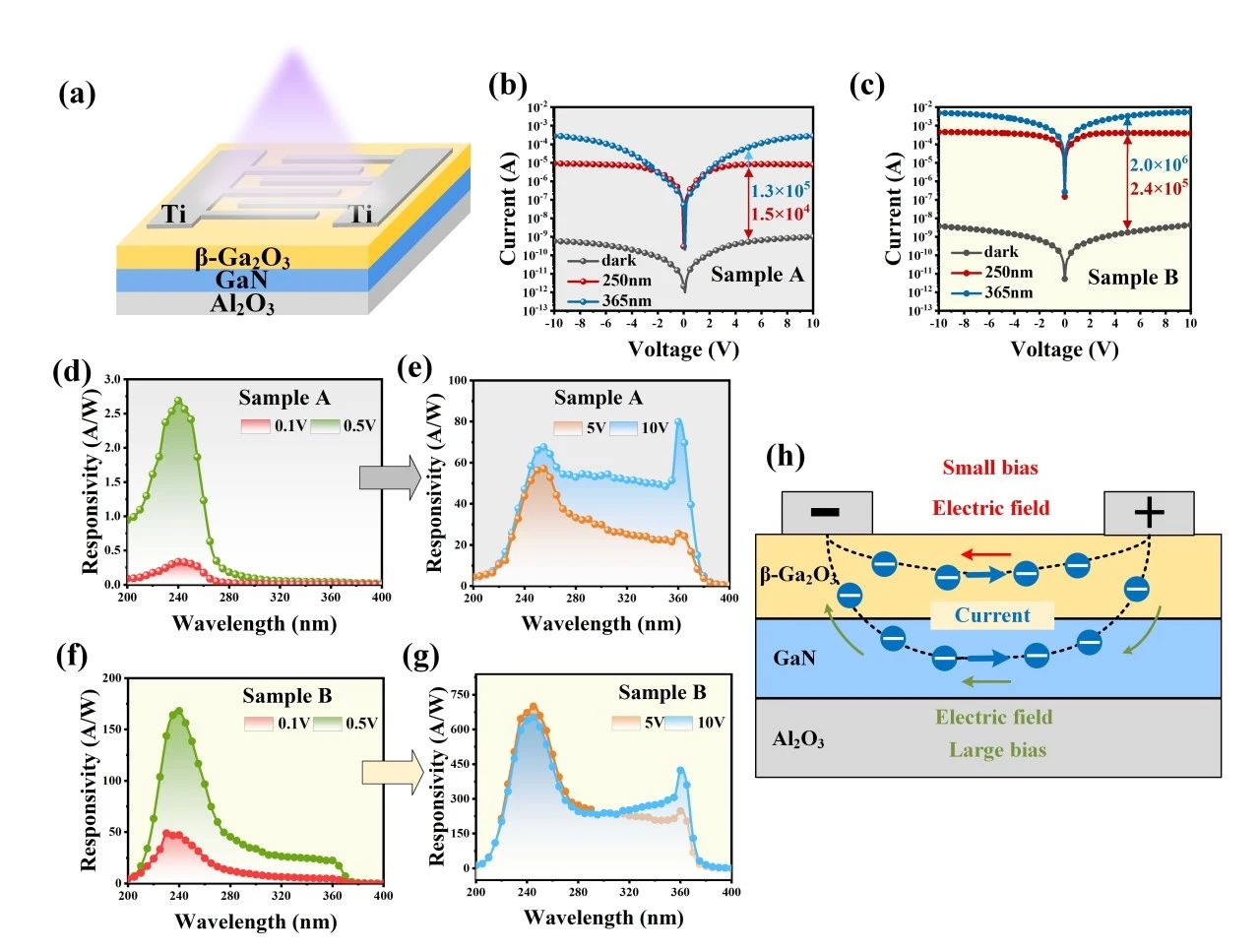
圖5. 樣品 A 和樣品 B 的 MSM 型的 β-Ga2O3/GaN 紫外光電探測器的光電性能表征:(a)器件結構示意圖。(b,c)I-V曲線。(d,f)低偏壓下的響應度光譜。(e,g)高偏壓下的響應度光譜。(h)電子輸運圖。
DOI:
doi.org/10.1016/j.mtphys.2025.101729
本文轉發自《亞洲氧化鎵聯盟》訂閱號
